玻璃基板概念股強勢爆發(fā) AI芯片封裝邁向“玻璃時代”
關(guān)鍵詞: 玻璃基板 CoPoS封裝 帝爾激光 沃格光電
4月17日,A股玻璃基板概念板塊延續(xù)強勢表現(xiàn)。帝爾激光收獲20cm漲停,沃格光電、彩虹股份雙雙封板,凱格精機、德龍激光盤中創(chuàng)出階段新高。市場資金對這一細分賽道的高度關(guān)注,直接導火索指向全球半導體巨頭臺積電最新釋放的技術(shù)路線信號——該公司正在搭建CoPoS封裝技術(shù)的試點產(chǎn)線,長遠目標是用玻璃基板取代傳統(tǒng)的硅中介層。
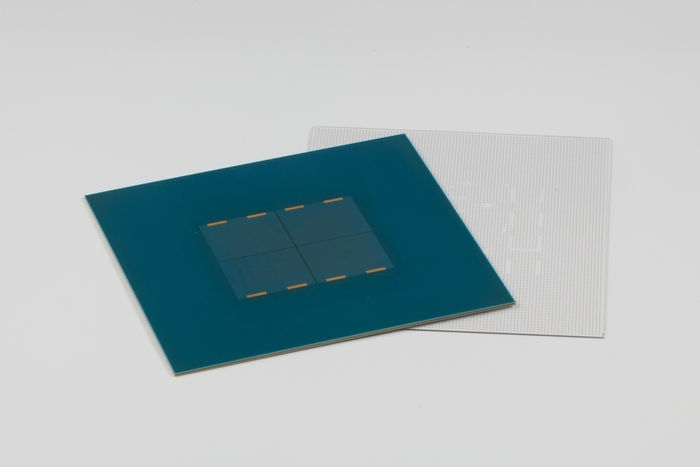
這不僅是封裝材料的簡單替換。在AI算力需求持續(xù)井噴、芯片復雜度指數(shù)級攀升的背景下,從有機基板到玻璃基板的躍遷,正成為延續(xù)摩爾定律、突破性能瓶頸的關(guān)鍵一戰(zhàn)。
臺積電釋放明確信號:CoPoS試點產(chǎn)線加速落地
4月16日,臺積電發(fā)布了一份超出市場預期的亮眼財報。更引人關(guān)注的是,公司董事長兼總裁魏哲家在財報會議上同步透露,臺積電正在搭建CoPoS封裝技術(shù)的試點產(chǎn)線,預計幾年后可進入量產(chǎn)階段。
魏哲家指出,目前臺積電先進封裝產(chǎn)能已是業(yè)內(nèi)規(guī)模最大,但供應(yīng)仍持續(xù)吃緊。公司在擴充自身產(chǎn)能的同時,也在持續(xù)與后段專業(yè)封測代工廠商(OSAT)密切合作。
據(jù)媒體此前報道,臺積電的CoPoS中試生產(chǎn)線已于今年2月開始向研發(fā)團隊交付設(shè)備,預計將于6月全面建成整條生產(chǎn)線。這一進度遠超市場預期,顯示出臺積電對玻璃基板技術(shù)路線的重視程度。
產(chǎn)業(yè)人士分析認為,臺積電延伸CoWoS技術(shù)路線至CoPoS,核心驅(qū)動力來自兩方面:一是面板化是克服先進封裝產(chǎn)能瓶頸的有效方案,隨著AI芯片光罩尺寸持續(xù)放大,方形面板可大幅提升利用率與產(chǎn)出效率;二是玻璃基板取代硅中介層,能夠有效降低成本、提升產(chǎn)能效率,以滿足AI芯片客戶龐大的需求。
為何是玻璃?傳統(tǒng)有機基板已逼近物理極限
AI算力激增帶來的散熱與封裝挑戰(zhàn),正在將傳統(tǒng)有機基板推向物理極限。高溫下的翹曲變形,已成為制約芯片性能提升的關(guān)鍵瓶頸。產(chǎn)業(yè)人士指出,面對英偉達Rubin GPU等大尺寸AI芯片,12吋晶圓僅能封裝7顆甚至4顆,效率明顯受限。
玻璃基板正是在這一背景下走上前臺。其核心競爭優(yōu)勢源于與傳統(tǒng)材料相比的顯著性能差異:
從材料特性來看,玻璃基板的熱膨脹系數(shù)可精準調(diào)控至3-5ppm/℃,與硅芯片高度匹配。高溫下翹曲量較有機基板減少70%以上,徹底解決了AI芯片封裝的核心機械失效難題。其表面粗糙度控制在1納米以下,比有機材料光滑5000倍,可支持0.5微米級線寬/間距的精細布線,互連密度可達傳統(tǒng)有機基板的10倍以上。
在性能層面,玻璃基板的介電常數(shù)約3.7,介電損耗較有機基板降低50%以上。英偉達實測數(shù)據(jù)顯示,采用玻璃基板的芯片信號傳輸速率提升3.5倍,帶寬密度提高3倍,功耗降低50%,精準匹配AI芯片、高速通信芯片的高頻傳輸需求。
更重要的是,玻璃基板可直接集成光引擎,為CPO(共封裝光學)技術(shù)提供核心支撐,助力數(shù)據(jù)中心突破功耗與帶寬瓶頸。1.6T/3.2T光互聯(lián)技術(shù)的落地,進一步放大了玻璃基板的市場價值。
巨頭競速:英特爾率先量產(chǎn),三星全鏈布局,臺積電聚焦工藝
面對這一確定性方向,全球半導體巨頭已展開激烈競逐,各自的技術(shù)路線和量產(chǎn)節(jié)奏正逐步清晰。
英特爾是這場競賽中的先行者。公司在亞利桑那州累計投入超10億美元建設(shè)玻璃基板專屬研發(fā)與量產(chǎn)線。今年1月,英特爾正式宣布玻璃基板技術(shù)進入大規(guī)模量產(chǎn)階段。其首款搭載玻璃核心基板的Xeon 6+“Clearwater Forest”服務(wù)器處理器,成為業(yè)界首個實現(xiàn)商業(yè)化落地的玻璃基板產(chǎn)品。英特爾數(shù)據(jù)顯示,玻璃基板有望支撐單個封裝實現(xiàn)1萬億晶體管集成,為延續(xù)摩爾定律提供核心支撐。
三星則通過全鏈條協(xié)同構(gòu)建技術(shù)壁壘。三星電機自去年起持續(xù)向蘋果提供玻璃基板樣品,用于其代號為“Baltra”的自研AI服務(wù)器芯片測試。三星電機在韓國世宗工廠運營試產(chǎn)線,已實現(xiàn)TGV深寬比10:1、銅填充空洞率低于0.5%的工藝突破。同時,三星電機與日本住友化學合資成立公司,計劃2026年下半年量產(chǎn)玻璃芯材料,目標2027年實現(xiàn)大尺寸基板的規(guī)模化量產(chǎn)。SKC旗下子公司Absolics也已向AMD等客戶提供量產(chǎn)級樣品。
臺積電則聚焦面板級封裝工藝創(chuàng)新,與康寧合作推進FOPLP(面板級扇出型封裝)與玻璃基板的融合。雙方聯(lián)合制定行業(yè)標準,將CTE公差壓縮至±0.5ppm/℃,介電常數(shù)離散度控制在2%以內(nèi),為規(guī)模化應(yīng)用掃清技術(shù)標準障礙。
國內(nèi)產(chǎn)業(yè)鏈多點突破
在海外巨頭加速布局的同時,國內(nèi)產(chǎn)業(yè)鏈也形成了“材料-工藝-設(shè)備”協(xié)同發(fā)展的格局。
彩虹股份在2026年4月的337調(diào)查中初裁獲勝,認定其自主研發(fā)的“616”新料方玻璃基板不侵犯美國康寧公司專利,為國產(chǎn)材料進入全球市場掃清了合規(guī)障礙。
沃格光電掌握全球少數(shù)的TGV全制程工藝,武漢基地年產(chǎn)10萬平方米TGV產(chǎn)線已實現(xiàn)量產(chǎn),成都8.6代線正籌備2026年量產(chǎn),產(chǎn)品已切入光模塊封裝供應(yīng)鏈。
帝爾激光作為國內(nèi)唯一量產(chǎn)TGV激光微孔設(shè)備的廠商,已完成面板級設(shè)備出貨,為行業(yè)規(guī)模化加工提供核心裝備支撐。公司在TGV激光微孔領(lǐng)域?qū)崿F(xiàn)晶圓級和面板級封裝激光技術(shù)全覆蓋。
此外,長電科技4月17日宣布,成功完成基于玻璃通孔(TGV)結(jié)構(gòu)與光敏聚酰亞胺(PSPI)再布線工藝的晶圓級射頻集成無源器件(IPD)工藝驗證,為5G及面向6G的射頻前端與系統(tǒng)級封裝優(yōu)化提供了新路徑。
天承科技則在玻璃基板通孔TGV金屬化領(lǐng)域提供創(chuàng)新解決方案,在深寬比10至15的TGV填孔電鍍加工效率和良率等關(guān)鍵指標上超越某國際品牌。
市場空間廣闊,商業(yè)化元年開啟
從市場規(guī)模來看,Yole Group預測,2025至2030年半導體玻璃晶圓需求將增長近三倍,2030年全球半導體玻璃基板市場規(guī)模有望突破80億美元。應(yīng)用場景上,玻璃基板將率先在AI服務(wù)器、HBM4存儲封裝、高性能計算等高端領(lǐng)域?qū)崿F(xiàn)商業(yè)化,后續(xù)逐步向汽車電子、可穿戴設(shè)備等領(lǐng)域滲透。
據(jù)統(tǒng)計,A股市場已有數(shù)十只玻璃基板概念股。其中,沃格光電、天和防務(wù)、凱盛新能等個股機構(gòu)一致預測今明兩年凈利增速均超100%;麥格米特、德龍激光、美迪凱等機構(gòu)一致預測增速均超50%。
從材料替代到工藝重構(gòu),從設(shè)備升級到生態(tài)重塑,玻璃基板正以其獨特的性能優(yōu)勢,撬動一個萬億級封裝市場的深刻變革。隨著臺積電、英特爾、三星等巨頭的量產(chǎn)節(jié)奏加速,2026年有望被市場定義為“玻璃基板商業(yè)化元年”。而在這場變革中,具備核心技術(shù)壁壘、率先實現(xiàn)量產(chǎn)突破的公司,將有望率先分享這一新興市場的增長紅利。







